Dünne Schichten für die organische Elektronik
Spectroskopische Ellipsometrie
Wir analysieren die uniaxial anisotrope, optische Dispersion von halbleitenden organischen Dünnschichten mit Hilfe der spektroskopischen Ellipsometrie im Wellenlängenbereich von 245 nm bis 1700 nm. Dabei verwenden wir Substrate mit 500 - 1000 µm SiO2, um die Empfindlichkeit der Methode für einen ausgewählten Wellenlängenbereich zu optimieren.
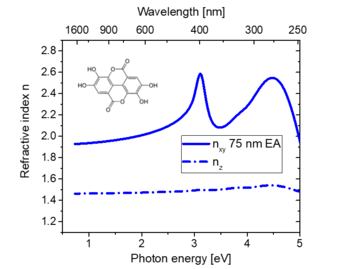
Optische Modellierung mit Hilfe von harmonischen Oszillatoren, Effektiv-Medium-Modellen oder Bspline-Funktionen werden zur Ableitung der folgenden Schichtparameter verwendet:
- Dicke und Rauhigkeit
- uniaxiale optische Dispersion: Brechungsindex n(λ) und Extinktionskoeffizient k(λ) oder ε1,ε2(Eph)
- Energie der elektronischen Übergänge und Energielage der Bandlücke
- Doppelbrechung Δn(λ)
- Ordnungsparameter S2
- Zusammensetzung mehrphasiger Schichten (in vol.%)
Röntgenbeugung unter streifendem Einfall (GIWAXS)
Wir identifizieren Gitterebenenabstände, die kristalline Textur und die durchschnittliche Orientierungsverteilung der Kristallite durch 2D-GIWAXS im Vakuum.
GIWAXS Aufnahmen werden hinsichtlich der Verwendung eines planaren Detektors korrigiert. Unter der Annahme isotroper Verteilung der Kristallite in der xy-Ebene wird die negative qxy-Richtung auf die positive Richtung abgebildet, um die blinden Bereiche des Detektors aus dem Bild zu entfernen. Radiale oder azimutale Schnitte werden durchgeführt, um die Reflexionsmaxima I(q) sowie die FWHM der Orientierungsverteilung der Kristallite I(χ) zu ermitteln. Die gesamte Datenanalyse wird mit selbst geschriebenen Phython-Skripten durchgeführt.

Bittrich, E. ; Domke, J. ; Jehnichen, D. ; Bittrich, L. ; Malanin, M. ; Janke, A. ; Uhlmann, P. ; Eichhorn, K.-J. ; Papamichail, A. ; Stanishev, V. ; Darakchieva, V. ; Al-Hussein, M. ; Levichkova, M. ; Fritz, T. ; Walzer, K. Morphology of thin films of aromatic ellagic acid and its hydrogen bonding interactions J. Phys. Chem. C 124 (2020) 16381-16390.
Röntgenreflektometrie (XRR)
Für die Analyse des kritischen Winkels der totalen externen Röntgenreflexion (TER) verwenden wir XRR (Cu Kα). Die Reflexionskurve wird mit der Software REFLEX modelliert (Vignaud, G.; Gibaud, A. J. Appl. Cryst. (2019), 52, 201-213), um die Dicke und Rauheit eines dünnen Films (oder eines Schichtstapels) sowie den energiespezifischen kritischen Winkel θc von TER zu erhalten. Aus θc wird die Massendichte des Filmmaterials berechnet.
IR-Spektroskopie an ultra-dünnen Schichten
Wir verwenden Infrarot-Reflexions-Absorptionsspektroskopie (IRRAS) und ATR-FTIR mit ATR-Si-Wafer-Einheit zur Analyse von Molekülschwingungen in nm-dünnen Schichten. Dabei konzentrieren wir uns auf Schwingungen, die an Wasserstoffbrücken-Wechselwirkungen beteiligt sind, und charakterisieren die temperaturabhängige Stabilität von Wasserstoffbrückenbindungen.
Normalisiertes ATR-FTIR-Spektrum von 10 nm Ellagsäure (EA) auf Si-Wafer. Das Kristallgitter von EA wird durch H-Bindungen stabilisiert.


